FuzionSC半导体贴片机精准完成封装叠加
发布时间:2021/08/02 16:00:36
来源:网络
封装叠加(PoP)就是采用两个或两个以上的BGA(球栅阵列封装)堆叠而成的一种封装方式。一般PoP叠层封装结构采用了BGA焊球结构,将高密度的数字或混合信号逻辑器件集成在PoP封装的底部,满足了逻辑器件多引脚的特点,主要应用在智能手机、数码相机等便携式电子产品中,作用非常广泛。
采用封装叠加的好处:
- 减少芯片占用面积,提高元件的集成度
- 缩短芯片间连线的长度,加快信号传输速度
- 可以单独测试元件,保障了更高的良品率
- 可自行组合来自不同供应商的元件,使产品的设计更为灵活
在贴片机上进行封装叠加的全过程

注:若要堆叠第三、四或更多元件,只需重复第二个步骤
在进行PoP时,重点在控制元器件之间的空间,如果没有足够的空隙,就可能产生应力,对可靠性和装配良率是致命的影响。除了基板和元器件外,基板制造工艺、元件封装工艺及SMT装配工艺均会影响空间关系。
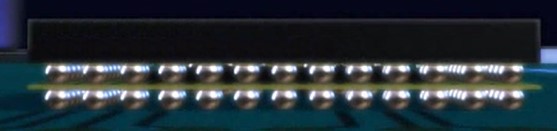
PoP装配要注意的地方:
- 焊盘的设计
- 阻焊膜窗口尺寸及位置公差
- 焊球尺寸公差
- 焊球高度差异
- 蘸取的助焊剂或锡膏的量
- 贴装精度
- 回流环境和温度
- 元件和基板的翘曲变形
- 底部器件模塑厚度


线性薄膜敷料器
免责声明:
本网站中未标注“来源:钜商网”而是标注“来源网络”的作品,均转载于第三方网站,本网站转载系出于传递信息之目的,并不意味着对作品观点的正确性、合法性以及作品内容的真实性负责,如有涉及版权问题,请联系平台删除。